
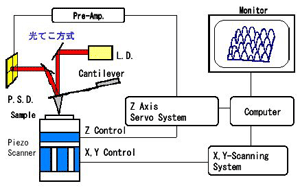
カンチレバー(片持ち梁)に探針を装着し、そのカンチレバーの先端にレーザ光を当てて、反射光の変位をフォトダイオードにより測定します(光てこ方式)。探針が試料表面に近づくと、探針と試料表面原子との原子間力によりカンチレバー(探針)が変位します。それを反射光で測定して、探針の変位が一定になるように試料を上下しながら横方向に試料を走査し、そのときの制御信号を2次元的にマッピングしたものが試料の表面形状(凹凸の様子)となります。カンチレバーおよび試料の位置変更は圧電セラミックス(piezoelectric ceramic)の膨張・収縮を利用して制御します。コンタクトAFMモードとカンチレバーを共振させ試料表面との引力、斥力を検出し表面形状を測定するDFMモードの測定ができます。
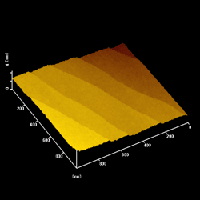
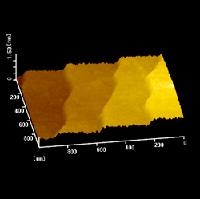
1ユニットセル(0.39nm)の高さで並んだテラスが明瞭に観測されます。