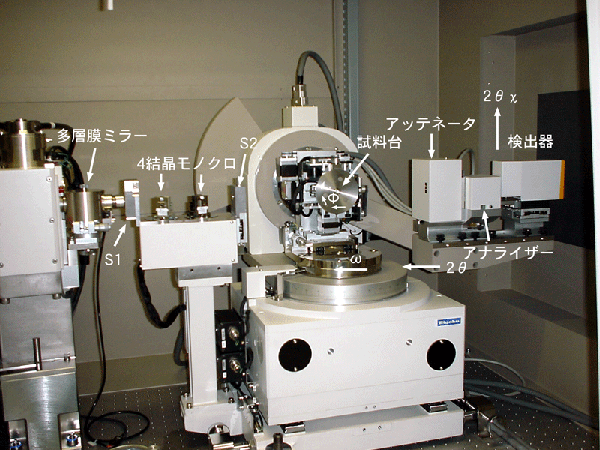


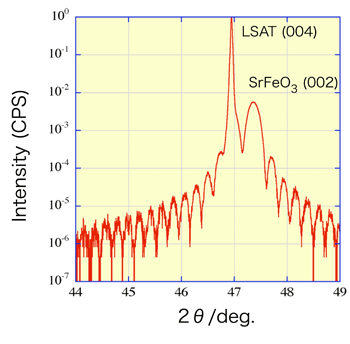


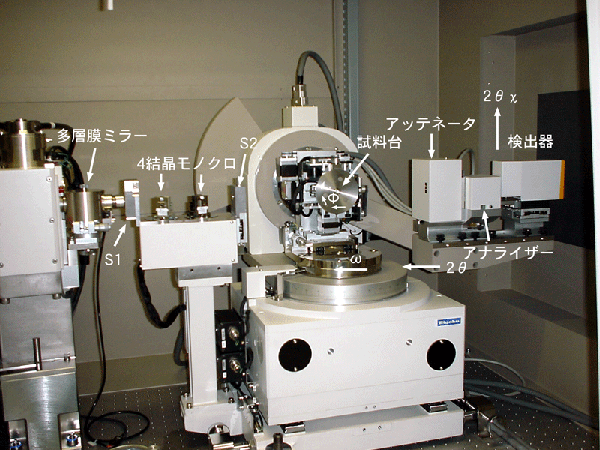 |
||||||||||||||
 |
||||||||||||||
| ATX-Gの光学系 図:理学電機 | ||||||||||||||
| 1. Out of - plane測定:薄膜の法線方向にX線の散乱ベクトルを向けた測定。薄膜の配向、他相の存在などがわかります。 | ||||||||||||||
 |
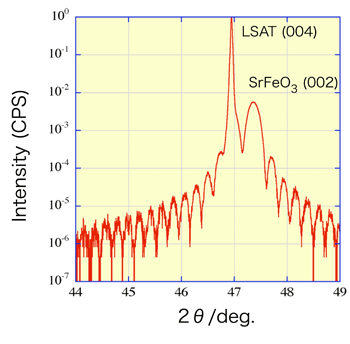 |
|||||||||||||
| out of -plane測定における配置。薄膜に対する入射角ω、検出器の角度2θ。ω、2θをカップルさせてc* 方向にスキャンします。 | LSAT(001)基板上に成長した、SrFeO3(001) 薄膜の回折パターンです。 | |||||||||||||
| 2. 逆格子測定:ω、2θを2次元逆格子平面内でスキャンさせ強度をマッピングします。薄膜および基板格子の面内方向での関係(一致・不一致)、歪みなどがわかります。 | ||||||||||||||
 |
||||||||||||||
| 3. In-plane測定:X線を薄膜表面にすれすれ(入射角度ω<1°)に入射し、全反射したX線により薄膜表面に対して垂直な格子(膜面方向に並んだ格子)からの回折を測定します。薄膜面内方向の格子定数が測定できます。 | ||||||||||||||
 |
||||||||||||||
| 図:理学電機 | ||||||||||||||